Process
薄膜製程主要設備

Evaporator
膜厚均勻性佳 (<3%)
最高加熱溫度〜350℃
溫度均勻性佳
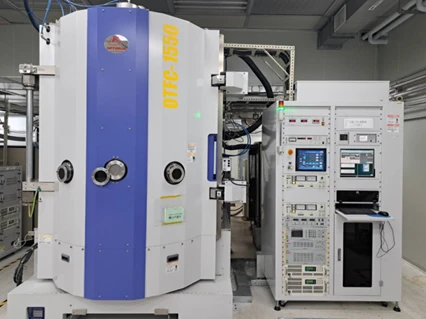
Distributed Bragg Reflector(DBR)
反射率可達99%以上
膜層緻密,覆蓋的光譜區域不會偏移
光譜均勻性≦±1%

Sputter
可低溫下進行
膜厚均勻性佳 (<1%)
膜層緻密性與附著性最佳

Plasma Enhanced Chemical Vapour Deposition(PECVD) (SiOx/SiNx)
較低沉積溫度
可調整薄膜內應力
良好的階梯覆蓋能力
可獲得緻密良好的膜質

Rapid Thermal Annealing(RTA)
升溫速度快 (20℃/秒)
最高加熱溫度〜900℃
溫度均勻性佳 (基板高低溫差<3℃)

α-step
薄膜厚度探針量測優點
表面粗糙度和輪廓測量
穩定性高容易操作
黃光製程主要設備

PR Coater
可調控變溫烤盤
良好的光阻塗布均勻性(內外〜1%)
自動化同時作業多種光阻塗佈
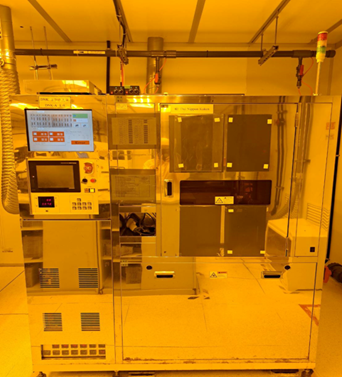
Mask Aligner
線寬解析度〜3μm
高精度的對準系統
產能與機台穩定性高
光罩成本較低

Stepper
較高的線寬解析度〜1.5μm
高精度的對準系統
機台穩定性較高

PR Developer
可調式變溫烤盤
良好的顯影塗布均勻性(內外〜1%)
蝕刻製程主要設備
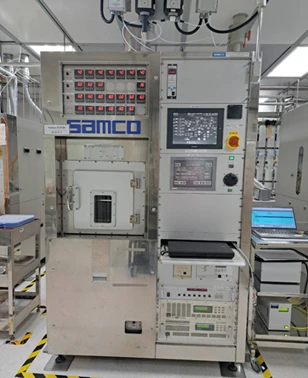
Inductively Coupled Plasma (ICP)
物理、化學複合蝕刻
(蝕刻方向控制佳)

Auto Wet Bench
全自動作業系統
自動供藥水系統
設備穩定性高
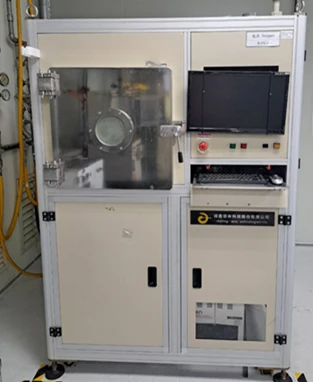
Plasma Clean
具有優越晶圓表面清潔能力
離子能量低不損傷晶片
